
- Автоматизация
- Антропология
- Археология
- Архитектура
- Биология
- Ботаника
- Бухгалтерия
- Военная наука
- Генетика
- География
- Геология
- Демография
- Деревообработка
- Журналистика
- Зоология
- Изобретательство
- Информатика
- Искусство
- История
- Кинематография
- Компьютеризация
- Косметика
- Кулинария
- Культура
- Лексикология
- Лингвистика
- Литература
- Логика
- Маркетинг
- Математика
- Материаловедение
- Медицина
- Менеджмент
- Металлургия
- Метрология
- Механика
- Музыка
- Науковедение
- Образование
- Охрана Труда
- Педагогика
- Полиграфия
- Политология
- Право
- Предпринимательство
- Приборостроение
- Программирование
- Производство
- Промышленность
- Психология
- Радиосвязь
- Религия
- Риторика
- Социология
- Спорт
- Стандартизация
- Статистика
- Строительство
- Технологии
- Торговля
- Транспорт
- Фармакология
- Физика
- Физиология
- Философия
- Финансы
- Химия
- Хозяйство
- Черчение
- Экология
- Экономика
- Электроника
- Электротехника
- Энергетика
ФЕДЕРАЛЬНОЕ АГЕНТСТВО СВЯЗИ 3 страница
Диффузионная ёмкость отсутствует в диодах Шотки, что делает их основным типом для указанных применений.
В диодах с p-n переходом диффузионную ёмкость удаётся уменьшить за счёт уменьшения толщины базы. На рис. 17 изображены p-n+ диоды с обычной (а) и тонкой базой (б):
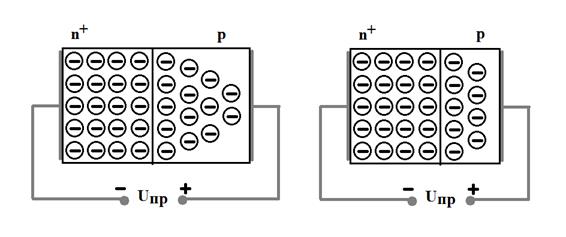
а) б)
Рис. 17
Т.к. у этих диодов эмиттером является сильнолегированная n-область, при прямом напряжении будет наблюдаться преимущественно электронный диффузионный ток. Рис. 17 демонстрирует распределение свободных электронов в обоих диодах. Очевидно, что в диоде с тонкой базой пространство, где существует диффузионный заряд, а также сам этот заряд, намного меньше. Поэтому здесь намного меньше и диффузионная ёмкость.
Согласно (17), диффузионную емкость p-n диода можно также уменьшить, уменьшив среднее время жизни неосновных носителей в базе τ.
Для этого, например, можно несколько увеличить концентрацию примеси в базе, что вызовет более интенсивную рекомбинацию и уменьшение τ.
Всё сказанное в равной степени относится к m-n и p-n переходам в интегральных схемах, где они используются не только в качестве диодов, но и в составе других элементов.
5.3. Стабилитрон
Стабилитрон – диод, предназначенный для стабилизации напряжения в режиме электрического пробоя. В таком диоде используется кремниевый p-n переход, отличающийся способностью работать при температурах до 1250 С и малой склонностью к возникновению теплового пробоя.
Схема включения стабилитрона представлена на рис. 18:
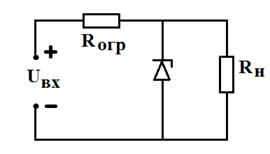
Рис. 18
Здесь Uвх – нестабильное напряжение источника питания – батареи, аккумулятора, солнечной батареи и т.п. На стабилитрон подано обратное напряжение, достаточное для возникновения электрического пробоя. Rогр не позволяет току в стабилитроне превысить предельно допустимое значение Iобр.макс. Тем самым исключается переход электрического пробоя в тепловой. Сопротивление нагрузки Rн включено параллельно стабилитрону. Поэтому напряжения на них равны и близки к напряжению пробоя Uпр. Напряжение на нагрузке, в зависимости от крутизны участка пробоя, остаётся более или менее стабильным.
5.4. ВАРИКАП
Варикап – диод, предназначенный для работы в режиме управляемой барьерной ёмкости Cб.
При обратном напряжении на p-n переходе ток в нём очень небольшой и, если есть переменная составляющая Nд, существует ёмкостная составляющая обратного тока Iобр. Ёмкостный обратный ток тем больше, чем больше Cб и выше частота переменной составляющей. Его величина может намного превосходить активную составляющую обратного тока. Поэтому p-n
переход при обратном напряжении можно использовать, как ёмкостный элемент. При прямом напряжении это невозможно, т.к. в этом случае появляется на несколько порядков больший активный прямой ток.
Подставив (26) в (16) с учётом того, что при обратном напряжении jк = jк0 + Uобр, получим:
Cб = [2εε0(jк0 + Uобр)(Nа + Nд)/qNаNд]½ (28)
Из (28) следует, что барьерной емкостью можно управлять, изменяя обратное напряжение на p-n переходе. Таким образом, p-n диод при Uобр является элементом с ёмкостью Cб, которую можно изменять.
При изготовлении варикапа полупроводник, тип примесей и закон их распределения в областях выбираются так, чтобы зависимость Cб(Uобр) была более сильной. В общем случае эта зависимость описывается выражением
Cб = [2εε0(jк0 + Uобр)(Nа + Nд)/qNаNд]m (29)
где m = 0,3…1.
Схема включения варикапа приведена на рис. 19. Здесь варикап
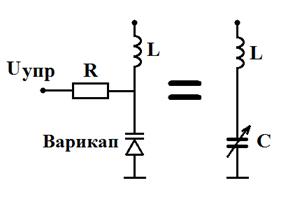
Рис. 19
включён как ёмкость последовательного колебательного контура. На него подаётся управляющее обратное напряжение Uупр. Изменяя это напряжение можно настраивать колебательный контур на необходимую резонансную частоту ω0 = (1/√LC).
5.5. Диоды на основе p-i-n структуры
Значительно улучшить импульсные, частотные и другие свойства диодов позволяет использование p-i-n структуры. В такой структуре между p и n областями располагается i-область собственного полупроводника, рис. 20.
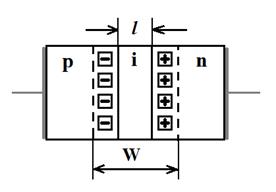
Рис. 20
Собственный полупроводник обладает на несколько порядков более низкой концентрацией свободных электронов и дырок по сравнению с p и n областями. Поскольку в таком полупроводнике примесей нет, эта область искусственно расширяет область неподвижного объемного заряда ионов при сохранении концентрации примесей в слоях p и n. В результате многократно возрастают w и сопротивление закрытого состояния, а также многократно уменьшается барьерная ёмкость.
Чтобы сохранить высокие значения градиентов концентрации ≈ dn/dw и ≈ dp/dw и, тем самым, сохранить большим диффузионный прямой ток, толщину i-области l делают не слишком большой:
l < L, (30)
где L – диффузионная длина – среднее расстояние, на котором концентрация диффундирующих в i-область носителей уменьшается в e раз из-за рекомбинации.
P-i-n диоды являются на сегодня одними из наиболее совершенных электронных ключей. Их обратный ток, барьерная ёмкость и сопротивление открытого состояния минимальны (у идеального ключа все эти параметры равны нулю).
5.6. Свето- и фото-диоды. Солнечные батареи
Устройство свето- и фото-диодов в целом одинаково, рис. 21. Одна из
областей их p-n перехода очень тонкая, что позволяет возникающему в переходе свету излучаться в окружающее пространство (светодиод) или позволяет внешнему свету проникать в переход (фотодиод).
В светодиодах используется излучательная рекомбинация, при которой рекомбинация каждой p-n пары порождает квант световой энергии.
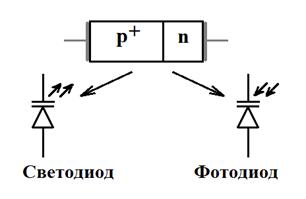
Рис. 21
Интенсивная рекомбинация и свечение возможны только при протекании в светодиоде прямого тока от внешнего источника.
Из (2) следует, что длина волны и цвет возникающего света определяются выражением:
λ = hc/Wз, (31)
где h – постоянная Планка, c – скорость света, Wз – ширина запрещённой зоны полупроводника. Согласно (31), цвет свечения определяется шириной запрещённой зоны полупроводника.
Кремниевые диоды излучают в инфракрасном, невидимом глазу диапазоне. Кремниевые светодиоды широко применяются, когда их работа не должна видимым светом мешать человеку, например, в пультах управления. Светодиоды на основе фосфида галлия производят красное свечение, на основе карбида кремния – жёлтое и т.д. Решена проблема получения любого цвета свечения. В частности, три различных светодиода – красный, зелёный и синий решают эту проблему в пикселах светодиодных экранов.
Быстро развивается теория и практика гетеропереходов – p-n переходов с полупроводниками различного типа в p- и n-областях. Им свойственно особенно высокое разнообразие возможных электрических и светотехнических характеристик.
В значительной степени решена проблема высокого к.п.д. светодиодов, который достигает нескольких десятков процентов. Поэтому, а также благодаря исключительно высокой надёжности, светодиоды интенсивно вытесняют лампы накаливания и газонаполненные приборы в осветительной и сигнальной аппаратуре.
В фотодиодах внешний свет проникает в p-n переход и, если выполняется соотношение (31), вызывает в нём генерацию электронно-дырочных пар. Поскольку в переходе имеется собственное электрическое поле, ускоряющее для неосновных носителей, последние разводятся полем в противоположные стороны и, тем самым, увеличивают дрейфовую составляющую тока. Равновесие диффузионного и дрейфового токов нарушается и в режиме с замкнутой внешней цепью в ней появляется фототок. В режиме с разомкнутой внешней цепью на освещённом p-n переходе появляется фото-э.д.с., также возникающая в результате нарушения равновесного состояния. В обоих случаях фотодиод можно использовать для регистрации падающего на него света. В частности, кремниевый фотодиод помещают на управляемых внешним пультом электронных устройствах. Если в пульте применён кремниевый светодиод, энергия квантов его света, согласно (2) и (31), достаточна для генерации электронно-дырочных пар.
Поскольку в освещаемом p-n переходе происходит преобразование световой энергии в электрическую, такие контакты используются в солнечных батареях. При идеально прозрачной атмосфере и в космосе мощность светового потока от Солнца на Земле достигает 1,4 кВт/м2.
6. СТРУКТУРА МЕТАЛЛ-ДИЭЛЕКТРИК-ПОЛУПРОВОДНИК.
МДП-ТРАНЗИСТОР
6.1. Основные свойства МДП-структуры
МДП-структура содержит металлический слой, слой диэлектрика и слой полупроводника, рис. 22. Если используется самый распространённый
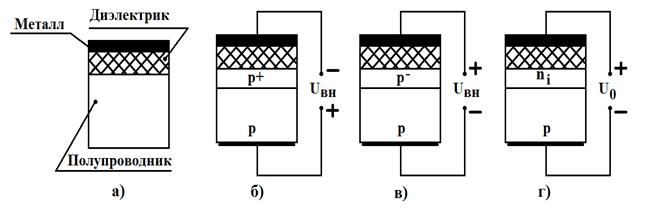
Рис. 22
полупроводник – кремний, то диэлектрик, как правило, двуокись кремния SiO2. Такой диэлектрик на поверхности кремния легко создаётся путём его окисления. Диэлектрический слой всегда очень тонкий, что обеспечивает проникновение электрического поля в полупроводник при подаче на структуру внешнего напряжения Uвн. Полупроводник может быть как n, так и p типа.
Пусть на МДП-структуру с полупроводником p-типа подано Uвн с полярностью: минус к металлу, плюс к полупроводнику (на металл подан потенциал, меньший, чем на p-полупроводник), рис. 22б. Электрическое поле в приповерхностном слое p-полупроводника будет направлять дырки в сторону, диэлектрика и вытеснять электроны из той области. Концентрация дырок в этом слое p+ будет повышенной (режим обогащения).
При подаче Uвн плюсом к металлу, рис. 22в, концентрация дырок в приповерхностном слое p- будет пониженной из-за вытеснения отсюда дырок созданным полем металлического слоя (режим обеднения). В то же время концентрация свободных электронов в приповерхностном слое будет расти из-за уменьшения вероятности их рекомбинации с дырками (см. (13)).
В результате уменьшения концентрации дырок и роста концентрации свободных электронов, при некотором пороговом напряжении U0 их концентрации сравняются и будут равны собственной концентрации ni, рис. 22г.
С дальнейшим ростом напряжения концентрация свободных электронов в приповерхностном слое превысит концентрацию дырок и тип проводимости в нем сменится с дырочного на электронный (режим инверсии).
Изменение состояния проводимости полупроводника под действием электрического поля называется полевым эффектом. Транзисторы, использующие полевой эффект, называются полевыми транзисторами.
6.2 МДП-транзистор с индуцированным каналом
В МДП-транзисторах используются свойства МДП-структуры, т.е. все их разновидности относятся к классу полевых транзисторов. В современной электронике в основном используются именно такие транзисторы [1, 5].
Устройство МДП-транзистора с индуцированным каналом поясняет рис. 23,а.
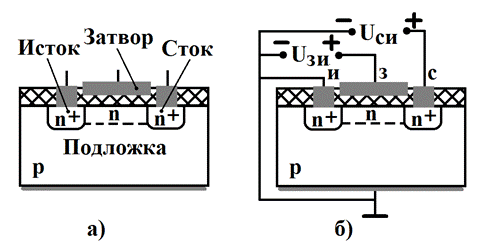
Рис. 23
Здесь МДП-структура дополнена двумя снабженными металлическими контактами «островками» n+-типа, между которыми может возникать канал n-типа (рис.23,б). Эти области называют стоком и истоком. Внутренние контакты с помощью обычных, омических контактов с металлом выведены на поверхность, что позволяет соединять их с внешними цепями. Благодаря высокой степени легирования, контакты обладают ничтожным сопротивлением.
На рис. 23,б изображён МДП-транзистор с необходимыми для работы подключениями. Здесь используется основная схема включения – с общим, или заземлённым истоком. Это название отражает очевидное: в такой схеме исток заземлён и является общим узлом для источников Uзи и Uси.
При подаче на затвор положительного напряжения Uзи, превышающего пороговое напряжение U0, обеспечивается режим инверсии МДП-структуры. В подзатворной области появляется слой полупроводника n-типа – канал. Канал электрически соединяет исток и сток. Поэтому, если подано напряжение на канал Uси, в канале появится ток канала. Ток канала, ток истока и ток стока равны между собой. Этот ток принято называть током стока Iс. По характеру Iс является дрейфовым током основных носителей.
Чем больше Uзи, тем больше толщина канала, концентрация свободных электронов в нём и поэтому больше ток Iс.
При любых Uзи < U0 режим МДП-структуры – обогащение или обеднение. Канала нет, исток и сток разделены полупроводником p-типа, ток между ними невозможен (закрытое состояние транзистора, отсечка).
Полное название такого транзистора – МДП-транзистор с индуцированным каналом n-типа, обусловлено тем, что под воздействием поля затвора в нем появляется (индуцируется) канал со свойствами полупроводника с электронной проводимостью.
Существуют и p-канальные МДП-транзисторы. В них используется МДП структура с полупроводником n-типа. Р-канал появляется при отрицательном напряжении Uзи < U0. Такие транзисторы менее распространены, т.к. подвижность дырок меньше, чем подвижность свободных электронов. При равных прочих условиях в n-канальном транзисторе ток в несколько раз больше.
6.3 Основные параметры МДП-транзистора
Основным средством описания электрических свойств МДП-транзистора является система параметров. Параметры используются, в частности, при компьютерном моделировании, являющимся главным «инструментом» разработки, изготовления и эксплуатации электронных устройств.
Одним из главных параметров МДП-транзистора является пороговое напряжение U0. От него зависит напряжение, мощность, размеры и стоимость источника питания МДП интегральных схем и отдельных МДП-транзисторов. Стоимость, размеры и масса источника может достигать половины этих характеристик самого электронного устройства (например, батареи гаджета).
Пороговое напряжение определяется свойствами материалов МДП-структуры и её главным размером – толщиной диэлектрического слоя d:
 , (32)
, (32)
где  – контактная разность потенциалов металл – полупроводник;
– контактная разность потенциалов металл – полупроводник;
d – толщина диэлектрика;
q – элементарный электрический заряд;
 – абсолютная электрическая постоянная;
– абсолютная электрическая постоянная;
 – относительная диэлектрическая проницаемость полупроводника и диэлектрика;
– относительная диэлектрическая проницаемость полупроводника и диэлектрика;
N – концентрация примеси в полупроводнике.
Большинство величин в (32) диктуются общими особенностями современной технологии – выбором типа полупроводника (кремний), диэлектрика (SiO2), металла (алюминий). Поэтому основным способом уменьшения U0 является уменьшение d. На сегодня d составляет доли нанометра , т.е. всего несколько межатомных расстояний. В результате достигнуты U0 ≈ 0,5 В. Это позволяет использовать источники питания с напряжением менее 1 В.
Другим важнейшим параметром МДП-транзистора является барьерная ёмкость затвор-канал Cзк:
Cзк = ε0εдS/d = ε0εдWL/d, (33)
где S – площадь затвора, W и L – ширина и длина затвора.
От Cзк зависит время отпирания и запирания транзистора, т.е. его импульсные и частотные свойства. Поэтому W и L должны быть минимизированы. Однако это противоречит обеспечению необходимого тока в канале Iс. В мощных МДП-транзисторах это противоречие разрешается увеличением W до нескольких метров, чем увеличивается площадь поперечного сечения канала и понижается плотность тока в нём.
Примером мощного МДП-транзистора является транзистор с Ic макс = 10 А, W = 2 м, L = 1 мкм. Проблема столь большой ширины канала в таких транзисторах решается изготовлением канала в форме меандра, рис. 24. Здесь изображены виды сверху на МДП-транзисторы с обычным (а) и увеличенным (б) отношением W/L.
Важным параметром является также удельная крутизна B [А/В2]. Она характеризует усилительные свойства МДП транзистора – зависимость полезного выходного тока Iс от входного напряжения Uзи. В первом приближении эта зависимость описывается двумя уравнениями:
Iс = 0,5B(Uзи - U0)2, при Uзи > U0 (открытое состояние)
(34)
Iс = 0, при Uзи < U0 (закрытое состояние) 
Рис. 24
Очевидно, что ток в канале Iс тем больше, чем больше коэффициент подвижности носителей в канале µ, его ширина W и проницаемость диэлектрика εдε0. Естественно также, что Iс уменьшается с увеличением толщины диэлектрика d (слабеет поле) и увеличением длины канала (растёт его сопротивление). Поэтому
B = µεдε0W/d·L (35)
Главный коэффициент, характеризующий усиление электронных элементов и устройств – коэффициент усиления по мощности Кр = Рвых/Рвх. У МДП-транзисторов Кр может быть очень большим. Это связано с тем, что вход транзистора, затвор отделён (изолирован) от канала диэлектрическим слоем. При постоянном входном напряжении Uзи входного тока Iз практически нет и Рвх = UзиIз ≈ 0. Однако при переменном входном напряжении из-за наличия ёмкости затвор-канал появляется комплексный входной ток. Этот ток и, следовательно, входная мощность тем больше, чем быстрее изменяется Uзи при отпираниях и запираниях транзистора или чем выше частота усиливаемого сигнала.
6.4. Статические характеристики МДП-транзистора
Статическими характеристиками называют графики зависимости одних постоянных напряжений и токов электронных элементов и цепей от других их напряжений и токов. Примерами статических характеристик являются ВАХ диода Шотки или p-n диода.
Транзистор всегда включается как четырёхполюсник, имеющий вход и выход. Входные характеристики связывают входные напряжения и токи, выходные характеристики связывают выходные напряжения и токи. Проходные, или переходные характеристики связывают входные токи или напряжения с выходными.
Примером статической характеристики является проходная характеристика МДП-транзистора, рис. 25. Она соответствует
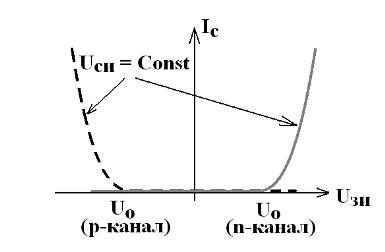
Рис. 25
зависимостям (34). Т.к. она связывает ток стока и напряжение на затворе, её называют также стоко-затворной характеристикой.
На рис. 25 штриховой линией изображена также стоко-затворная характеристика МДП-транзистора с индуцированным каналом р-типа. В таком транзисторе пороговое напряжение отрицательное, канал существует при отрицательных Uзи.
На рис. 26 изображены выходные характеристики МДП-транзистора.

Рис.26
Они отражают зависимость выходного тока Iс от выходного напряжения Uси. Этот ток зависит ещё и от входного напряжения Uзи. Поэтому выходные характеристики обычно изображаются в виде семейства характеристик. Каждая из характеристик семейства соответствует некоторому неизменному Uзи. В результате семейство характеристик отображает обе важнейшие зависимости: Iс = f1(Uси) и Iс = f2(Uзи).
Выходные характеристики МДП-транзисторов имеют два характерных участка. Первый участок соответствует малым значениям Uси. В этой области канал по всей своей длине одинаков, его сопротивление Rк определяется только неизменным значением Uзи и поэтому Rк = const. При неизменном сопротивлении зависимость тока в канале Iс от напряжения на канале Uси подчиняется закону Ома. Отсюда название этого участка – омический, или резистивный. Он представляет собой отрезок прямой из начала координат.
С дальнейшим увеличением Uси форма канала начинает изменяться, рис. 27. Потенциал истока в схеме с общим истоком равен нулю и неизменен. Поэтому разность потенциалов затвор-канал и сила поля вблизи истока также неизменны. Канал здесь сохраняет исходную толщину и концентрацию свободных электронов. Вблизи стока, потенциал которого равен Uси, разность потенциалов затвор-канал равна Uзи - Uси. Поэтому с ростом Uси поле затвора
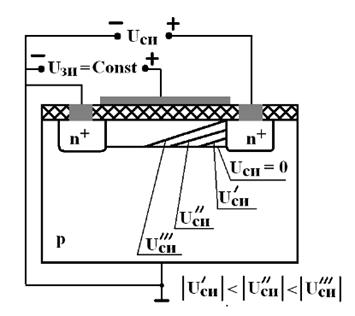
Рис. 27
здесь ослабевает. Канал вблизи стока становится тоньше, Rк увеличивается. Омический участок характеристики сменяется участком насыщения. Ток стока не уменьшается, так как одновременно растет напряжение между стоком и истоком, увеличивающее скорость дрейфа носителей по каналу. При дальнейшем повышении Uси произойдет пробой p-n-прехода сток-подложка, и это приведет к резкому повышению тока стока за счет обратного лавинного тока перехода.
Такие же по форме выходные характеристики имеют МДП-транзисторы со встроенным каналом, рис. 28.
Они находят ограниченное применение из-за необходимости затрачивать энергию на поддержание состояния отсечки транзистора изготовления дополнительного n-слоя между истоком и стоком. Этот слой выполняет функцию канала, который существует в таком транзисторе и при Uзи = 0. Как и в транзисторах с индуцированным каналом, в МДП транзисторах со встроенным каналом в зависимости от напряжения на затворе наступает обогащение или обеднение канала. При достаточно сильном обеднении,
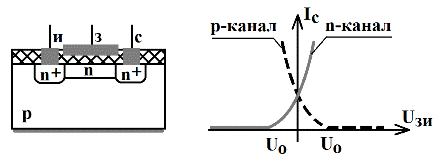
Рис. 28 Рис. 29
т.е. при Uзи < U0, наступает режим инверсии полупроводника под затвором. Канал исчезает, транзистор запирается. Стоко-затворная характеристика МДП-транзистора со встроенным каналом n-типа изображена на рис. 29. Здесь же штриховая линия соответствует p-канальному варианту транзистора.
Выходные характеристики всех рассмотренных в разделе 6.5 транзисторов имеют только количественные отличия, рис. 26.
Общепринятые условные обозначения всех МДП-транзисторов приведены в Приложении 2.
6.5. МДП-транзистор с плавающим затвором
Устройство МДП-транзистора с плавающим затвором изображено на рис. 30.
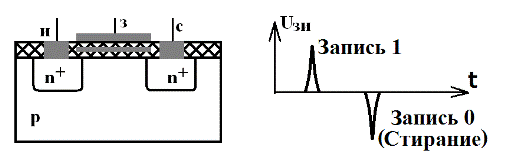
Рис. 30 Рис. 31
В таком транзисторе есть два металлических слоя, выполняющих функцию двух затворов.
На верхний, обычный затвор, может быть подано внешнее напряжение Uзи в виде короткого импульса, рис. 31. Возникает электрическое поле, которое заряжает внутренний, плавающий затвор. В зависимости от знака поданного Uзи, заряд плавающего затвора будет +Q или –Q. Этот заряд, в свою очередь, создает вокруг себя электрическое поле, проникающее в полупроводник. При +Q в полупроводнике возникает режим инверсии. Образуется n-канал, транзистор открыт. При отрицательном Uзи плавающий затвор приобретает заряд –Q. Канал исчезает (закрытое состояние).
Главное свойство такого транзистора - заряд плавающего затвора не исчезает после отключения Uзи. Благодаря тому, что плавающий затвор со всех сторон окружён высококачественным диэлектриком, пути для тока разряда нет и заряд затвора сохраняется в течение нескольких лет. В течение этого же времени сохраняется открытое или закрытое состояние. Таким образом, МДП-транзистор с плавающим затвором обладает свойствами ячейки памяти, способной хранить 1 бит информации.
Запись открытого состояния (условно единицы) осуществляется подачей на затвор короткого положительного импульса, рис. 31. Стирание прежнего заряда и переход в закрытое состояние (запись нуля) осуществляется подачей короткого отрицательного импульса.
МДП-транзисторы с плавающим затвором и их разновидности получили исключительно широкое распространение в современной электронике. На их использовании, в частности, основывается работа флеш-памяти.
6.6. Арсенид-галлиевый полевой транзистор
В арсенид-галлиевом полевом транзисторе (в дальнейшем GaAs-транзистор), как и в МДП-транзисторе, используется полевой эффект – влияние электрического поля на полупроводник. И хотя в GaAs-транзисторе нет диэлектрического слоя, подобием его является слой обеднённого полупроводника на границе металло-полупроводникового контакта Шотки.
В работе МДП- и GaAs-транзисторов много общего. Устройство GaAs-транзистора поясняет рис. 32. Сам GaAs кристалл примесей не содержит. Благодаря большой ширине запрещённой зоны собственная концентрация носителей заряда беспримесного GaAs настолько мала, что по электропроводности этот полупроводник приближается к диэлектрикам. Поэтому проблемы влияния полупроводника, окружающего транзистор, не существует.
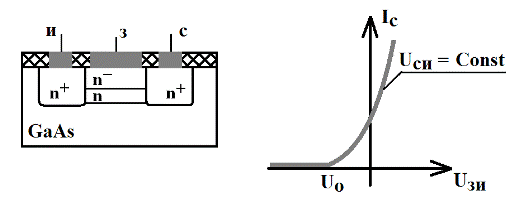
Рис. 32 Рис. 33
Канал в таком транзисторе изготавливается сразу, в виде слоя полупроводника n-типа. Металл затвора выбирается так, чтобы контакт между затвором и каналом являлся контактом Шотки. Как в любом другом таком m-n контакте, в приграничной части полупроводника возникает обеднённый слой.
При подаче на затвор относительно подложки положительного напряжения наступает обогащение канала. Обеднённый слой сужается, канал расширяется. Ток канала Iс увеличивается (Uси ≠ 0). При подаче отрицательного напряжения на затвор обеднённый слой расширяется. При пороговом напряжении –U0 канал исчезает, транзистор запирается. Типичная стоко-затворная характеристика GaAs-транзистора изображена на рис. 33.
Использование GaAs-транзистора при положительных напряжениях Uзи > 0,2…0,4 В приводит к отпиранию m-n перехода и появлению в нём значительного тока. В основной схеме включения полевых транзисторов, схеме с общим истоком, это входной ток Iз. Поэтому возрастает входная мощность и снижается усиление транзистора. При Uзи > 0,2…0,4 В такой транзистор не используется.
|
|
|
© helpiks.su При использовании или копировании материалов прямая ссылка на сайт обязательна.
|