
- Автоматизация
- Антропология
- Археология
- Архитектура
- Биология
- Ботаника
- Бухгалтерия
- Военная наука
- Генетика
- География
- Геология
- Демография
- Деревообработка
- Журналистика
- Зоология
- Изобретательство
- Информатика
- Искусство
- История
- Кинематография
- Компьютеризация
- Косметика
- Кулинария
- Культура
- Лексикология
- Лингвистика
- Литература
- Логика
- Маркетинг
- Математика
- Материаловедение
- Медицина
- Менеджмент
- Металлургия
- Метрология
- Механика
- Музыка
- Науковедение
- Образование
- Охрана Труда
- Педагогика
- Полиграфия
- Политология
- Право
- Предпринимательство
- Приборостроение
- Программирование
- Производство
- Промышленность
- Психология
- Радиосвязь
- Религия
- Риторика
- Социология
- Спорт
- Стандартизация
- Статистика
- Строительство
- Технологии
- Торговля
- Транспорт
- Фармакология
- Физика
- Физиология
- Философия
- Финансы
- Химия
- Хозяйство
- Черчение
- Экология
- Экономика
- Электроника
- Электротехника
- Энергетика
Пробой р-п-перехода
Электрофизические свойства полупроводников. Электронно-дырочный переход.
Для создания различных полупроводниковых приборов, применяемых в электронных устройствах, используют кристаллические структуры, состоящие из чередующихся областей полупроводников п- и р-типа. В зависимости от типа полупроводникового прибора, число областей с разными типами проводимости может быть две и более. Основу любого полупроводникового прибора составляют электронно-дырочные переходы.
Электронно-дырочным переходом (или кратко р-п-переходом) называют тонкий слой между двумя областями полупроводникового кристалла, одна из которых имеет электронную, а другая – дырочную электропроводность.
Технологический процесс создания электронно-дырочного перехода может быть различным: сплавление, диффузия одного вещества в другое, эпитаксия (ориентированный рост одного кристалла на поверхности другого) и др. По конструкции электронно-дырочные переходы могут быть симметричными (пп = рр) и несимметричными (пп > > pp или пп < < рр, при этом концентрации основных носителей отличаются в 100-1000 раз), резкими и плавными, плоскостными и точечными и др. Однако для всех типов переходов основным свойством является несимметричная электропроводность, при которой в одном направлении кристалл пропускает ток, а в другом – не пропускает.
Устройство полупроводникового кристалла с электронно-дырочным переходом показано на рисунке 1. 5. Одна часть этого кристалла легирована (обогащена) донорной примесью и имеет электронную проводимость (п-область). Другая часть легирована акцепторной примесью и имеет дырочную проводимость (р-область). Кроме основных носителей в обеих частях кристалла имеется небольшая концентрация неосновных носителей (соответственно дырок в п-области и электронов в р-области).
Сразу после создания р-п-перехода при отсутствии внешнего электрического поля электроны из п-области стремятся проникнуть в р-область, где концентрация электронов значительно ниже. Аналогично, дырки из р-области перемещаются в п-область. В результате встречного движения противоположных зарядов возникает так называемый диффузионный ток р-п-перехода. Электроны, перешедшие в р-область, рекомбинируют с дырками, в результате чего в р-области вблизи границы раздела двух типов полупроводников появятся отрицательно заряженные неподвижные ионы акцепторной примеси. В свою очередь, уход электронов из п-области приводит к появлению в приконтактной части п-области не скомпенсированных положительно заряженных неподвижных ионов донорной примеси.
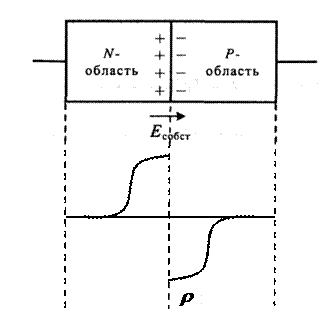
Рисунок 1. 5 – Упрощенная структура р-п-перехода
Одновременно с перемещением электронов, из р-области в п-область наблюдается диффузионное перемещение дырок. Этот процесс сопровождается созданием таких же неподвижных положительных и отрицательных ионов вблизи границы раздела двух типов полупроводников в п-области и р-области.
Двойной слой неподвижных электрических зарядов (ионов) создает в области р-п-перехода объемный пространственный заряд, наличие которого приводит к появлению внутреннего электрического поля (  на рисунке 1. 5). Вектор этого поля направлен таким образом, что оно препятствует дальнейшему диффузионному движению основных носителей зарядов. Поэтому через короткий промежуток времени на р-п-переходе устанавливается динамическое равновесие, он становится электрически нейтральным, а ток через р-п-переход – равным нулю.
на рисунке 1. 5). Вектор этого поля направлен таким образом, что оно препятствует дальнейшему диффузионному движению основных носителей зарядов. Поэтому через короткий промежуток времени на р-п-переходе устанавливается динамическое равновесие, он становится электрически нейтральным, а ток через р-п-переход – равным нулю.
Разность потенциалов, образованную приграничными зарядами, называют контактной разностью потенциалов yк (потенциальным барьером), преодолеть которую носители без «сторонней помощи» не могут. Вместе с тем возникшее в р-п-переходе поле не препятствует движению неосновных носителей через переход, так как для них оно будет ускоряющим. Неосновные носители создают дрейфовый ток р-п-перехода.
Распределение плотности объемного заряда r в р-п-переходе при отсутствии внешнего электрического поля показано на рисунке 1. 5.
Р-п-переход представляет собой слой полупроводника с низкой концентрацией подвижных носителей зарядов (обедненный слой). Этот слой имеет повышенное электрическое сопротивление. Поскольку концентрация основных носителей зарядов в областях полупроводника различна, то и ширина обедненного слоя в р- и п-областях также будет различной (в области с меньшей концентрацией основных носителей она будет шире).
Контактная разность потенциалов yк на р-п-переходе зависит от концентрации примесей в областях полупроводника и определяется выражением:
 , (1. 1)
, (1. 1)
где  – температурный потенциал;
– температурный потенциал;
пi – концентрация носителей зарядов в нелегированном полупроводнике;
k » 1, 38 × 10-23 Дж/К – постоянная Больцмана;
Т – абсолютная температура, К;
q » 1, 6× 10-19 Кл – заряд электрона.
При нормальной температуре (Т = 300 К) jТ » 26 мВ. Контактная разность потенциалов для германия при этом имеет значение 0, 2-0, 3 В, а для кремния – 0, 6-0, 7 В.
Высоту потенциального барьера можно изменять приложением внешнего напряжения к р-п-переходу. Если внешнее напряжение создает в р-п-переходе поле, вектор напряженности которого совпадает по направлению с вектором напряженности внутреннего поля (рисунок 1. 6, а), то высота потенциального барьера увеличивается, при обратной полярности приложенного напряжения высота потенциального барьера уменьшается (рисунок 1. 6, б). Если полярность поля, создаваемого приложенным внешним напряжением, противоположна полярности собственного (внутреннего) поля и внешнее напряжение равно контактной разности потенциалов, то потенциальный барьер исчезает полностью.

а

б
Рисунок 1. 6 – Прямое и обратное смещение р-п-перехода
Если приложенное напряжение снижает потенциальный барьер, то оно называется прямым, а если повышает – то обратным.
Обратный ток (iобр) в р-п-переходе вызывается неосновными носителями одной из областей, которые, дрейфуя в электрическом поле области объемного заряда, попадают в область, где они уже являются основными носителями. Так как концентрация основных носителей существенно превышает концентрацию неосновных, то появление незначительного дополнительного количества основных носителей практически не изменит равновесного состояния полупроводника. Таким образом, обратный ток зависит только от количества неосновных носителей, появляющихся на границах области объемного заряда. Его предельное значение (обозначим IТ) называют обратным током насыщения или тепловым током.
Внешнее приложенное напряжение определяет скорость перемещения этих носителей из одной области в другую, но не число носителей, проходящих через переход в единицу времени. Следовательно, обратный ток через р-п-переход является током проводимости и не зависит от высоты потенциального барьера, т. е. он остается постоянным при изменении обратного напряжения на переходе.
При прямом смещении p-п-перехода появляется диффузионный ток, вызванный диффузией основных носителей, преодолевающих потенциальный барьер. Пройдя р-п-переход, эти носители попадают в область полупроводника, для которой они являются неосновными носителями. Концентрация неосновных носителей при этом может существенно возрасти по сравнению с равновесной концентрацией. Такое явление носит название инжекции носителей.
Таким образом, при протекании прямого тока через переход из электронной области в дырочную будет происходить инжекция электронов, а из дырочной области в электронную будет происходить инжекция дырок.
Диффузионный ток зависит от высоты потенциального барьера и по мере его снижения увеличивается экспоненциально:
 , (1. 2)
, (1. 2)
где U – напряжение на p-n-переходе.
Кроме диффузионного тока прямой ток содержит ток проводимости, протекающий в противоположном направлении, поэтому полный ток при прямом смещении р-п-перехода будет равен разности диффузионного тока и тока проводимости:
 . (1. 3)
. (1. 3)
Полученное уравнение является аналитическим представлением вольтамперной характеристики (ВАХ) р-п-перехода. На рисунке 1. 7 приведены ВАХ германиевого и кремниевого р-п-переходов.
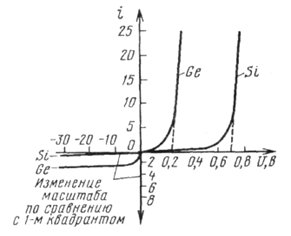
Рисунок 1. 7 – Примеры ВАХ электронно-дырочных переходов
Как следует из выражения (1. 3), при незначительном обратном напряжении на р-п-переходе (составляющем всего единицы вольт) экспонента стремится к нулю и, следовательно, обратный ток через р-п-переход определяется только тепловым током. Из рисунка 1. 7 видно, что обратный ток р-п-перехода на основе кремниевого материала существенно меньше, чем обратный ток р-п-перехода на основе германиевого (например, у кремниевых диодов IT = 1-10 мкА, у германиевых – IT = 100-150 мкА).
Пробой р-п-перехода
Под пробоем р-п-перехода понимают значительное уменьшение его дифференциального обратного сопротивления, сопровождающееся резким возрастанием обратного тока при увеличении приложенного обратного напряжения.
На рисунке 1. 8 показана обратная ветвь ВАХ р-п-перехода. На начальном участке обратной ветви ВАХ (участок 0 – 1) при увеличении обратного напряжения, приложенного к переходу, ток растет медленно. Увеличение тока обусловлено, в основном, увеличением количества носителей, принимающих участие в создании тока, возникающих за счет термогенерации в самом р-п-переходе. Кроме того, увеличение тока может быть связано с не идеальностью р-п-перехода. В этом случае за счет наличия дефекта кристаллической решетки возникают токи утечки.

Рисунок 1. 8 – Пробой в электронно-дырочном переходе
Участок 1 – 2 называют пред пробойным участком. В точке 2 происходит пробой р-п-перехода. Различают два вида пробоя: электрический (участок 2 – 3) и тепловой (участок 3 – 4). Электрический пробой характерен тем, что при практически неизменном падении напряжения на переходе ток резко увеличивается. Для теплового пробоя характерно резкое уменьшение напряжения на переходе при одновременном увеличении обратного тока.
Существует два вида электрического пробоя: лавинный и туннельный. Вид пробоя, в первую очередь, зависит от толщины р-п-перехода, то есть от концентрации примесей в р- и п- областях. Лавинный пробой наблюдается в широких р-п-переходах в слаболегированных полупроводниках. Он происходит при достаточно высокой напряженности электрического поля (0, 8 × 105 - 1, 2 × 105 В/см2), когда электроны, проходящие через р-п-переход, приобретают энергию, достаточную для ионизации атомов кристаллической решетки. Возникающие при этом вторичные электроны приобретают энергию за счет действия поля и также ионизируют атомы кристаллической решетки в р-п-переходе. Таким образом происходит лавинообразный процесс нарастания носителей, что приводит к резкому увеличению тока.
Туннельный пробой происходит в узких р-п-переходах, когда напряженность поля достигает величины порядка (6-7) × 105 В/см2 и энергетические зоны р- и п-областей смещаются таким образом, что оказывается возможным переход электронов из зоны проводимости п-области в валентную зону р-области и наоборот. Такой переход носит название туннельного, а поскольку электроны для такого перехода практически не затрачивают энергии, то ток через р-п-переход резко растет.
Тепловой пробой возникает за счет нарушения теплового равновесия в области р-п-перехода. За счет возрастания тока iобр мощность, выделяемая в р-п-переходе, увеличивается. Это приводит к увеличению температуры р-п-перехода и, следовательно, к увеличению тока термогенерации. В итоге ток через р-п-переход лавинообразно увеличивается и наступает тепловой пробой.
Процессы, происходящие при электрическом пробое, являются обратимыми, т. е. после уменьшения напряжения Uобр ток iобр уменьшается. Тепловой пробой – необратим. В результате теплового пробоя р-п-переход разрушается и полупроводниковый материал приобретает свойства проводника.
|
|
|
© helpiks.su При использовании или копировании материалов прямая ссылка на сайт обязательна.
|